인텔 파운드리(Intel Foundry)는 미국 오리건주 힐스보로 R&D 구역에 위치한 상업용 ‘고개구율(High Numerical Aperture, High NA) 극자외선(Extreme Ultraviolet, EUV)’ 노광장비(리소그래피 스캐너) 조립을 완료했다고 발표했다.
노광 전문업체 ASML사 제품인 인텔의 하이 NA EUV 장비 ‘트윈스캔 EXE:5000(TWINSCAN EXE:5000)’은 인텔의 첨단 공정 로드맵 개발에 사용될 준비를 위해 여러 조정 단계를 진행 중이다. 이 신규 장비는 인쇄된 이미지를 실리콘 웨이퍼에 투사하기 위한 광학 설계 변경을 통해 차세대 프로세서의 해상도와 기능 확장을 획기적으로 개선할 수 있다.
하이 NA EUV 장비는 첨단 칩 개발과 인텔 18A 이후 차세대 프로세서 생산에서 핵심적인 역할을 할 예정이다.
최신 세대의 노광장비를 도입하기 위해 인텔은 오리건에 있는 D1X 팹 확장에 30억 달러 이상을 투자하여 27만 평방피트(약 2만 5천 제곱미터, 7천5백평 이상)의 클린룸 공간을 추가해 2022년에 Mod 3를 열었다.
ASML은 최근 하이 NA 연구소에서 10nm(나노미터) 폭의 선을 인쇄했다고 발표한 바 있다. 이는 지금까지 인쇄된 회로 중 가장 미세한 라인이다.
전체 스펙에서 실행하기 위한 사전 단계로 장비의 광학 장치, 센서, 스테이지가 대략적인 보정을 완료한 후 획기적인 이미지가 전사되었다. 풀 필드 광학 노광 시스템을 사용하여 10nm 집적도의 회로를 인쇄할 수 있는 ASML 기술은 하이 NA EUV 장비의 상용화를 위한 핵심 단계이다.
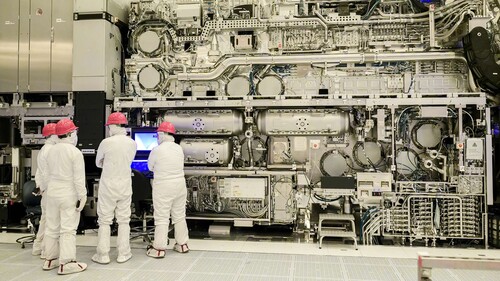
인텔 파운드리의 다른 주요 공정 기술 역량과 결합하여, 하이 NA EUV는 기존 EUV 장비보다 최대 1.7배 미세하게 전사할 수 있을 것으로 예상된다. 이를 통해 2D 기능의 확장이 가능해 집적도가 2.9배 향상될 것으로 보인다.
0.33NA EUV 대비 하이 NA EUV(또는 0.55NA EUV)는 유사한 기능에 대해 노출당 더 적은 광량으로 더 높은 이미징 콘트라스트를 제공하여 각 레이어를 인쇄하는 데 필요한 시간이 줄어들다.
인텔은 2025년 인텔 18A 제품 검증을 시작으로 인텔 14A 생산에 이르기까지 첨단 칩을 개발 및 제조할 때 다른 노광 공정과 함께 0.33NA EUV 및 0.55NA EUV를 모두 사용할 예정이다. 인텔은 비용과 성능을 위해 첨단 공정 기술을 최적화하고 있다.
인텔은 2021년 하이 NA EUV를 도입할 계획을 발표했으며, 2022년에 인텔과 ASML은 첨단 기술 주도를 위해 계속 협력하겠다고 발표한 바 있다. 인텔은 시간당 200개 이상의 웨이퍼 생산성을 갖춘 차세대 트윈스캔 EXE:5200 시스템을 도입하여 업계의 하이 NA EUV 시스템의 최초 사용자가 될 예정이다.
NA(Numerical Aperture)는 빛을 수집하고 초점을 맞추는 능력을 측정하는 척도이다. 하이 NA EUV 기술은 웨이퍼에 패턴을 투영하는 데 사용되는 광학 장치의 설계를 변경함으로써 해상도와 트랜지스터 크기를 크게 향상시킬 수 있다. 이러한 초미세 트랜지스터를 생성하려면 새로운 트랜지스터 구조와 다른 공정 단계의 개선이 필요하며, 인텔은 최초의 하이 NA EUV 시스템 통합과 병행하여 개발 중인 다른 공정 단계도 개선 중이다.
마크 필립스(Mark Phillips) 인텔 펠로우 겸 인텔 파운드리 로직 기술 개발 부문 노광, 하드웨어 및 솔루션 담당 디렉터는 “하이 NA EUV 추가로, 인텔은 업계에서 가장 다방면의 노광장비를 보유하게 되었으며, 2025년 이후 인텔 18A를 넘어 미래 공정을 추진할 역량을 갖추게 되었다.”라고 밝혔다.
관련기사
- 인텔, 11억 5천만 뉴런 지원하는 ‘뉴로모픽 시스템’ 공개
- 더 빠르고 강화되는 5G, 보안 솔루션 투자도 가속화
- PLI 구현하면 기업의 주요 지표 ‘25% 상승’
- [기고] 생성AI가 가져올 비즈니스 가치 극대화 3대 요소
- 인텔, 기업용 AI 구현 지원하는 ‘가우디 3∙AI 개방형 시스템 전략’ 발표
- 인텔, 파운드리 사업 재무 구조 개편∙수익성 확대 방안 발표
- 인텔, AI PC 가속화 프로그램 확대
- 인텔, 데스크톱 프로세서 ‘14세대 인텔 코어 i9-14900KS’ 출시
- 인텔 코어 울트라 탑재 vPro 플랫폼, AI PC 시장 확대
- 인텔, 공정 로드맵 확장 “2030년까지 파운드리 2위 목표”
- 인텔, 한스 촹 아시아 태평양 지역 총괄 선임
- 보안 팹리스 기업 ICTK, 내달 코스닥상장
- 인텔이 지향하는 '사회적 책임·포용·지속가능·실현'
- 인텔, 내년 18A 기반 클라이언트 및 서버용 프로세서 생산 예고

